特征尺寸已经从90nm向7nm迈进。然而,由于随着晶体管特征尺寸已日益接近物理极限,量子效应和短沟道效应越来越严重,内部自发地通过源极和漏极,导致漏电流增加,进而限制了晶体管的进一步缩小。因此,按照摩尔定律的方式,通过缩小晶体管特征尺寸来提升集成电路性能、降低功耗变得越发困难。晶体管将会快速地接近约5nm的极限栅极长度,因此探索新的沟道材料和器件结构是推动产业继续发展的两条极为重要的路线D、晶圆级等先进封装是超越摩尔一个至关重要的研究应用方向。以3D集成封装为例,垂直于晶圆或平面方向上进行堆叠,集成电路技术由二维平面向三维方向发展,该技术分段实现,首先实现几层的3D堆叠,随着时间的推移,堆叠芯片层数将会不断增加。采用全新结构的3D集成是推动等不同类型的器件和软件的复杂集成,以及新材料和先进的芯片堆叠技术,都要基于3D集成技术。另外,由于的延迟交货和功率限制的综合影响,制造商无法进一步缩小器件尺寸,垂直堆叠芯片设备(含三维集成技术)正成为大势所趋。
芯片堆叠封装存在着4项挑战,分别为晶圆级对准精度、键合完整性、晶圆减薄与均匀性控制以及层内(层间)互联。随着摩尔定律逼近材料与器件的物理极限,源于微机电系统(Micro Electro Mechanical Systems,MEMS)制造技术的晶圆级封装键合技术逐渐进入集成电路制造领域,成为实现存储器、逻辑器件、射频器件等部件的三维堆叠同质/异质集成,进而提升器件性能和功能,降低系统功耗、尺寸与制造成本的重要技术途径,对满足集成电路高集密度、高功能密度和高性能集成的迫切需求,突破国内自主可控平面集成能力不足的瓶颈,实现集成电路由平面集成向三维立体集成的跨越式发展有重要的战略价值。因此,英特尔三星、华为、高通罗姆、台积电等知名企业及众多高校、科研院所均围绕晶圆级封装键合开展了设备、器件、工艺的研究。
键合(Bonding)属于后道封装过程,分为晶圆-晶圆键合(Wafer-to-Wafer,W2W)和芯片-晶圆键合(Die-to-Wafer,D2W)。键合主要指将两片表面清洁、原子级平整的同质或异质半导体材料经表面清洗和活化处理,在一定条件下直接结合,通过范德华力、分子力甚至原子力使两片半导体材料成为一体的技术。W2W 是指通过化学或物理反应将晶圆与晶圆、晶圆与玻璃基板或其他材料圆片永久结合起来的工艺。键合过程为,在外能量的作用下,两个晶圆接合界面上的原子相互反应形成共价键,从而使晶圆接合并达到一定的界面键合强度;D2W 指在划片工艺之后,将从晶圆上切割的芯片黏贴在封装基板(引线框架或印刷电路板)上。芯片键合工艺可分为传统和先进方法,传统方法采用芯片键合(Die Bonding)和引线键合(Wire Bonding),先进方法采用倒装芯片键合(Flip Chip Bonding)、混合键合(Hybrid Bonding)等技术。键合、解键合市场发展较晚,是从第二代半导体磷化铟、砷化镓开始发展的,最先开始使用键合/解键合的厂商是稳懋,主要是做射频器件、光通器件及激光器件时,会用到薄化工艺,后来逐渐发展到先进封装层面,目前重点是台积电的应用为主。键合广泛应用在芯片的减薄工艺,追求芯片越来越小、效率越来越高、成本越来越低是各个芯片厂商追求的趋势。随着碳化硅产业的起步和发展,目前键合/解键合工艺涵盖了第一代、第二代、第三代半导体。
晶圆键合(wafer bonding),从名字上就可以同传统封装中应用到的引线键合wire bonding和贴片键合die bonding所区分。bonding可以被翻译为接合,从直观印象上更方便于理解这一工艺和过程。从键合方式上来分类,晶圆键合可以分为永久键合和临时键合。区别也顾名思义,永久键合后无需再解键合(debonding),而临时键合还需要解键合,将接合在一起的晶圆重新打开。从界面材料来讲,分为带中间层的胶键合,共晶键合,金属热压键,无中间层的熔融键合(fusion bonding)和阳极键合等。
以前晶圆键合业务主要面向封装领域的客户。如果一颗一颗晶圆去做封装,效率会很低,如果用整一个晶圆片去做封装,效率就会高很多。如今越来越多其他领域的公司也开始用键合技术。当芯片的集成度越来越高,成本也会越来越高。半导体产业的研发生产要同时兼顾技术和成本。如今各芯片企业不再追求更小的制程,而是将各种功能的芯片叠层起来,进行3D封装。实现3D封装的首要因素是晶圆片要薄,薄的晶圆可以更容易实现TSV穿孔工艺,而且如果芯片叠起来过厚就不利于用在终端设备中。因此目前行业内都在往50微米到100微米的级别靠拢,甚至有一些客户在往更薄的级别努力。一个50微米厚度的12吋晶圆片像纸一样薄,很难进行后续的光刻、湿制程等工艺,为了节省成本,各企业都希望不要更换现有的设备。这样就产生了临时键合的需求。我们用一个载片托住这片晶圆,做完减薄后仍然在这片晶圆上进行后续的所有工艺,最后再完整无损地将晶圆片和载片打开,清洗后就可以进行切片作业了。
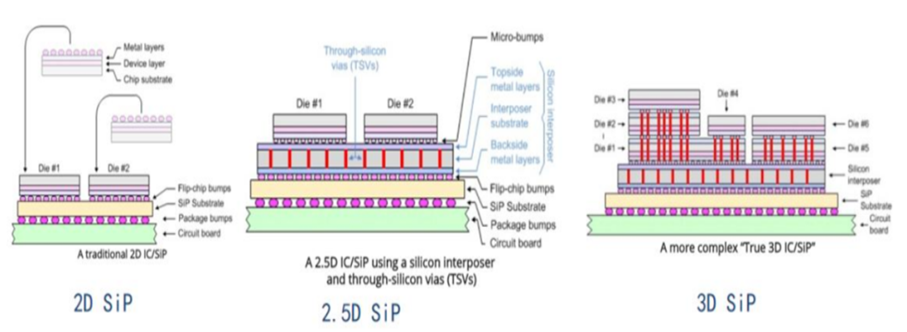
02晶圆键工艺过程(一)晶圆键合工艺过程及键合分类如图2所示,晶圆键合工艺过程为:首先将待键合的一组晶圆进行预处理、清洗、视觉对准,进而通过不同方法实现晶圆对的键合。晶片接合后,界面的原子受到外力的作用而产生反应形成共价键结合成一体,并使接合界面达到特定的键合强度,称之为永久性键合。若借助粘结剂将晶片接合,也可作为临时键合,通过将器件晶圆固定在承载晶圆上,可为超薄器件晶圆提供足够的机械支撑,保证器件晶圆能够顺利安全地完成后续工艺制程,如光刻、刻蚀、钝化、溅射、电镀和回流焊。
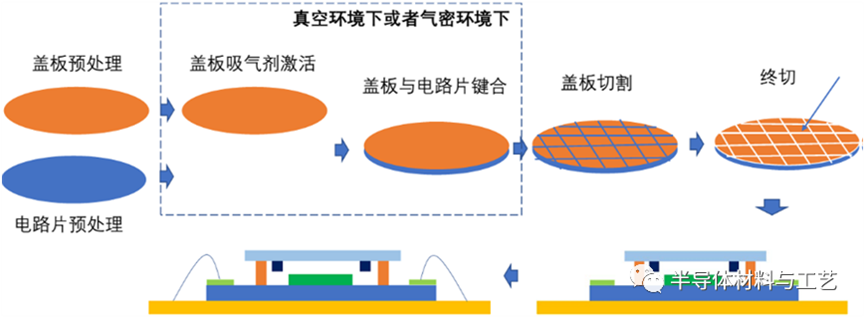
具体的晶圆键合工艺可按照键合材料、键合手段、应用场景分类,方法不尽相同,按照键合工艺对晶圆键合分类(见表1)。晶圆级键合是半导体器件物理、材料物理化学、精密机械设计、高精度自动控制等多学科交叉的科学技术领域。晶圆键合工艺中晶圆尺寸的扩大、芯片特征尺寸的缩小、异质材料之间的热失配及晶格失配等重要技术问题还有待解决。
国外利用超高真空Ar快速原子束表面活化键合工艺实现了大面积、高强度的晶圆级键合,但我国在大面积、高强度晶圆级键合理论与工艺领域能力仍有待提高。晶圆键合及烘烤激活对晶圆表面温度均匀性及翘曲变形有十分严格的要求。温度均匀性取决于设备结构、加热工艺以及晶圆自身的热物理性能,翘曲变形则受温度均匀性、外加机械力以及晶圆自身力学性能的影响。传统的研究多采用实验试错的方法,没有将上述因素协同考虑,难以获得优化的结构工艺参数,导致键合可靠性及器件良率大大下降。国际上的高水平研究团队通常结合先进的数值仿真手段及多变量多目标优化方法,综合考虑包含热辐射、热传导在内的热场以及包含热应力、机械应力在内的应力场等多物理场之间的复杂耦合作用机理,开展对晶圆键合和烘烤激活工艺参数的协同优化,从而大大提高键合品质及器件良率。

从界面材料来讲,晶圆键合又分为:(1)没有中间层的晶圆键合,包括融熔键合、铜-铜混合键合和阳极键合;(2)使用中间层的晶圆键合,中间层诸如玻璃浆料的绝缘体,或是在共晶键合和热压键合中采用的金属,包括胶键合、共晶键合、金属热压键合。如图3:
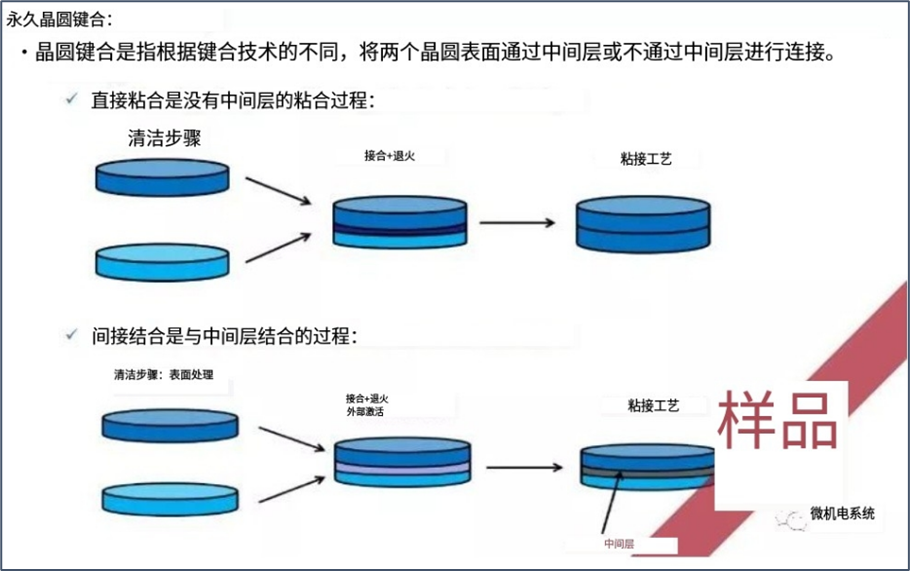
1、键合条件影响键合质量的内在因素是晶片表面的化学吸附状态、平整度及粗糙度;外在因素主要是键合的温度和时间。通常还需要加压来克服表面起伏与增加表面原子间的成键密度,来达到提高键合强度的目的。决定键合成功与否的基本条件: (1)几何条件:利用键合技术可以有效解诀晶格失配的问题,要保证两个键合晶片的表面平整度与弹性模量的差异要小。
(2)机械条件:键合所需的表面需要非常平滑,表面的粗糙度要求达到2nm以上,配合化学机械研磨(C雔}任)实现。
(3)物理条件:由于磊晶或长晶的过程往往会有一些缺陷,如:晶界(grainboundaries) 大、晶格错位(dislocation)双尖峰(spikes)等,这些也需使用CMP的方式去除。
(5)能量条件:在热处理的过程中,温度可能会造成表面残余物质的化学反应,键合过程中引入热应力导致形变等对器件不利的结果。
为了达到良好的键合质量,通常需要对欲键合的晶片进行前期准备,主要通过表面处理、预键合及热处理三个过程。
2、键合界面的性质(1)键合界面的位错和空洞。 除了硅硅直接键合这种同质材料键合之外,大部分都是通过异质材料进行键合。而由于两个键合的材料不同,晶片之间必然存在着热失配及晶格失配等问题。键合界面将会产生应力,为了应力弛豫,界面处会形成一定的位错,会严重影响器件的性能。此外,晶片表面会有一定的杂质、多孔层结构和空洞。这些杂质和多孔层结构的产生可能是由于表面未清洗洁净及界面附近的原子重组造成的,空洞是晶片在退火时产生的气泡引起的。
键合晶片的界面状态会影响晶片的电学和光学性质,通过I-籚特性及PL谱等测试手段来分析界面处的键合情况,有助于更好的了解界面的性质变化,从而改进方法来提高界面的电学和光学性能。
对于晶片来说,晶片内部与晶片表面的原子有不同的排列方式。当表面某处的原子排列出现中断时,表面处就会产生额外的能量此时中断处附近的原子如果仍以内部结构的形式排列,系统的自由能会明显增加。为了恢复稳定的排列方式,表面处的原子会进行一定的调整来降低附加的自由能。实现调整的方式主要有两种:通过晶片表面自行调整和借由外界条件调整。
对于自行调整方式,由于晶片内部受力与晶片表面受力的情况显著不同,表面的晶格常数会随之发生改变。改变后晶片表面的原子与内部原子的排列形成不同的排列方式。如重构、台阶化等。以这种方式排列之后表面会形成本征表面态。
通过外界条件的调整方式,晶片表面原子之间存在不饱和键,易吸附外来的杂质。吸附杂质的同时还进行电子交换,原有的表面太发生变化形成非本征表面态。通过以上两种调整方式都可以达到减低表面能的目的,从而使晶片内外系统达到稳定。
晶片的表面悬挂键越多,表面能越大,键合时两个晶片之间的原子越容易相互作用。而键合界面处随着原子的不断相互作用形成越来越多的共价键,键合晶片的界面越牢固,键合强度越大。3、晶圆键合的难度3D堆叠、晶圆级等先进封装方案可以采用多种形式,具体取决于所需的互连密度。图像传感器和高密度存储器可能需要将一个芯片直接堆叠在另一个芯片上,并通过硅通孔连接,而系统级封装设计可能会将多个传感器及其控制逻辑放在一个重新分配的层上。对于设计师来说,关键问题不是如何物理地包含单个模块,而是如何集成一个复杂的系统。尽管如此,从相对低密度的扇出型晶圆级封装到高密度芯片堆叠的所有形式的三维集成都存在一些具有挑战性的组装问题。 首先,为了确保一致的机械和电气连接,并方便进行任何进一步的光刻步。
上一篇:济南量子技术研究院济南量子技术研 下一篇:滨海县陈涛镇开展节后企业复工复产


